HBM4,大战打响!
2024-04-27 12:32
AI的火热,除了带动GPU的大红大紫以外,背后的重要存储技术HBM也在过去几年冲上了风口浪尖。最近,SK hynix和三星的业绩和动作标明,HBM在未来大有可为。
据路透社报道,HBM 芯片目前占通用内存市场的 15%,而去年这一比例为 8%。SK 海力士在 HBM 市场拥有最大的市场份额,由于生成式 AI 热潮刺激了对 Nvidia GPU 的需求,该市场的需求猛增。它是占据 AI GPU 市场 80% 份额的 Nvidia 的 HBM3 内存唯一供应商,并于 3 月份开始量产最新一代 HBM3E。美光和三星等竞争供应商正在开发自己的 HBM 产品,以阻止 SK 海力士主导市场。
而围绕着HBM,厂商们也都各出奇招。除了针对现有技术进行深耕,并围绕未来的HBM 4,悄然吹响进攻号角(关于HBM4,可以参考文章《HBM4要来了》)。另外,说明一下,因为笔者没找到美光关于HBM技术的更多介绍,所以本文中就没有谈到他在HBM技术的展望和分享,希望大家补充。
SK海力士坚持MR-MUF
据SK hynix所说,目前,封装技术已经超越了“将芯片电气连接,并保护芯片免受外部冲击”的传统作用,而是成为实现差异化产品性能的重要技术。SK海力士HBM以硅通孔技术(TSV:Through Silicon Via)、批量回流模制底部填充(MR-MUF:Mass Reflow-Molded Underfill)先进封装工艺作为核心技术,赢得了卓越的市场声誉。
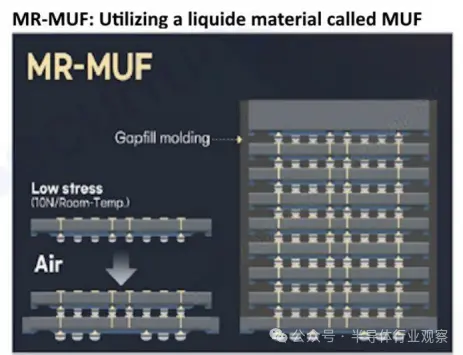
其中,TSV技术常见,而在MR-MUF中,批量回流焊(MR)是通过融化堆叠芯片之间的凸块,让芯片互相连接的技术。模塑底部填充(MUF)是在堆叠的芯片之间填充保护材料从而提高耐久性和散热效果的技术。使用MR-MUF,则可同时封装多层 DRAM。
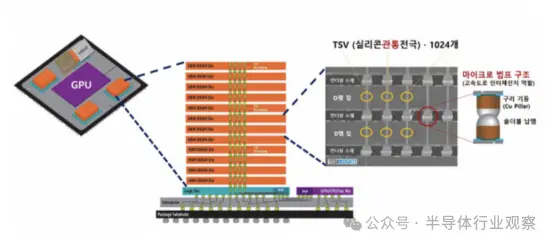
具体而言,从技术上流程看,在 DRAM 下方,有连接芯片的铅基“凸块”。MR 技术涉及加热并同时熔化所有这些凸块以进行焊接。连接完所有 DRAM 后,接下来会进行称为 MUF 的过程来保护芯片。注入以优异散热性而闻名的环氧密封剂来填充芯片之间的间隙并将其封装。然后通过加热和加压使组件硬化,从而完成 HBM。
SK海力士将这一过程描述为“像在烤箱中烘烤一样均匀地施加热量,并一次粘合所有芯片,使其稳定且高
相关推荐
英特尔介绍多项封装技术突破,包括用于HBM4和UCIe的EMIB-T先进封装HBM4 时代内存巨头加速混合键合技术导入,产品最快明年亮相
三星电子:计划在HBM4世代为客户开发多样化定制HBM内存
<返回首页
Copyright CmsTop.com
2026年04月14日 06:00:23